BGBM
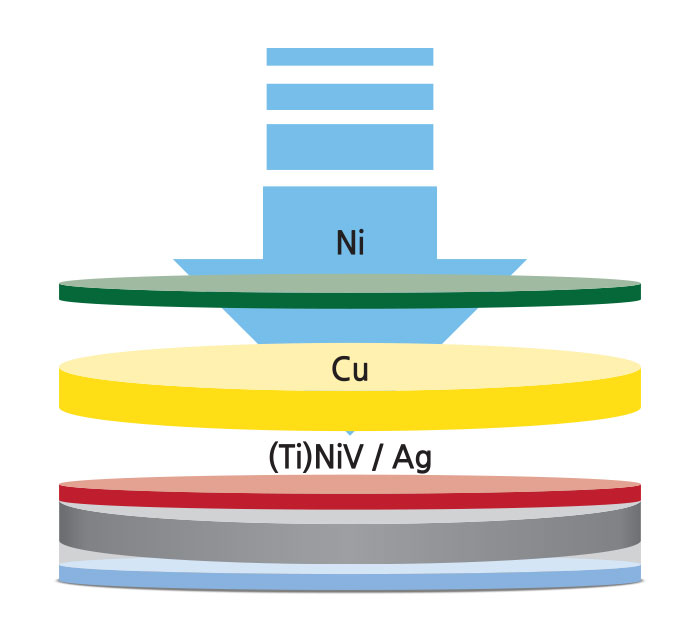
LB Semicon的BGBM(Back Grinding Back Metal)技术适用于所有使用电池的电子电路,如智能手机,导航,电视,音频,服务器电源等使用MOSFET(Metal-Oxide Semiconductor Field Effect Transistor)产品的电源设备。
是可以应用的技术。
为了实现客户满意度,公司从现有的商业化MOSFET PKG流程中,以差异化技术为基础开发了"拐点"业务。
实现是企业的愿景。
通过重新建立工艺流程,我们拥有最好的技术,通过确保晶圆水平30~50um全磨光技术,通过减少晶圆厚度,实现了低电阻和低热传导。
响应30um水准的BSM(Back Side Metal)也准备根据客户要求进行修改和补充。
运用公司优势技术的电子设备电池,通过减少备用电源,增加寿命,通过彻底的检查过程,为顾客对最佳产品的满意度提供解决方案。
为了更进一步地成为最佳合作伙伴,我们正尽最大努力,通过过程优化,不断开发以最佳产品为基础的产品和减少信用证(Lead Time)。
COF(Chip on film)是美国制造的一种带式自动保税(TAB, Tape Automated Bonding),是替代线式保税的一种,至今一直在不断发展。
通过将芯片和胶片作为衬底连接起来,它起到与外部电子元件交换信号的作用。
主要应用于电视,显示器,笔记等。
最近广泛应用于汽车,智能手机等高性能显示器产品,具有以下特点。
MOSFET PKG Key Tech.
TBDB (Temporary Bonding and Debonding), Full Grinding, Plating, EDS Test, Laser/Blade Saw, Tape&Reel
 Back Grinding
Back Grinding Back Side Metal
Back Side Metal MOSFET Top View
MOSFET Top View Tape&Reel
Tape&Reel
BGBM (Backside Grinding, Backside Metallization)
Unique TBDB method of LB Semicon is applied to provide differentiated BGBM service
-
[ Spec & Target ]
- Wafer Thickness (8 inch) : 30 ~ 100 um
- Sputter Target : NiV/Ag (Opt. Ti AV)
Feature
-

- Wafer Thinning Technology
- Silicon Thickness Target : Min 30um
- Full Grinding through TBDB Method
- Cost Reduction through increasing Net die(about 7%)
- Wafer Crack Free through TBDB Method
- Wafer Warpage Free through Carrier Wafer Bonding
-
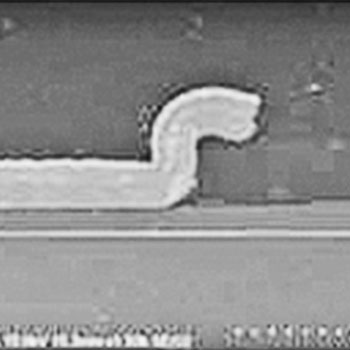
- Offering FSM(Front Side Metal) Servic
- CNA Bumping available
- ENIG / ENEPIG(Under develop)
- Full Tern-Key Solution including FSM
-
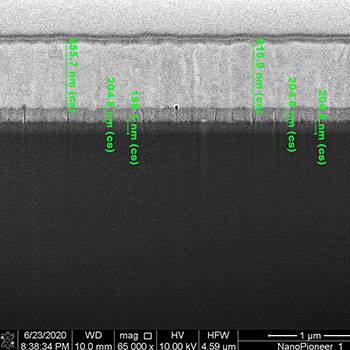
- Various Sputtering deposition available
- Ti / NiV / Ag
- NiV / Ag
- Ti / Cu
-
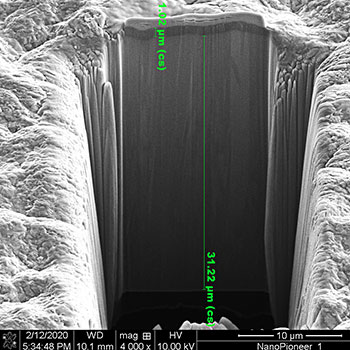
- Optimized BSM Thickness condition
- Cu/Ni
- Cu Thick target 50um for thin wafer
- Low Rsson characteristic for Mosfet
-

- Clear Cut Lin
- Blade Sawing
- Laser Sawing
-
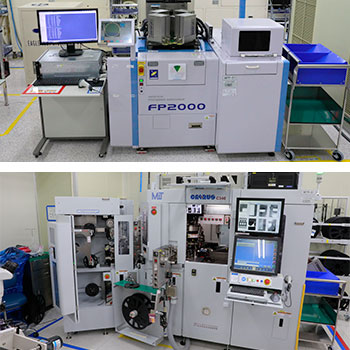
- Test & Tape and Reel
- Probe Test available(ETS200)
- Tape and Reel packing available
- Offering Full Turn-Key Solution
Service
- Turn-Key Solution -> Reducing Lead Time
- Customized Mass Production -> Meeting Customer needs